HVIGBT损坏机理及失效分析
发布日期:2022-01-14 14:52
// 讲座概述
本系列讲座旨在分享功率半导体的原理和相关应用知识,已发布的第1-30讲主要介绍了功率半导体的基础知识。从第31讲起为大家介绍HVIGBT的一系列相关知识,以帮助读者全面了解HVIGBT的工作原理、特性和正确应用方法。
对于电气设备调试阶段以及市场中退回的故障品进行器件深入分析,可以帮助我们找到HVIGBT发生失效的可能原因。由于造成HVIGBT失效的原因很多,通常我们使用故障树分析(FTA, Fault Tree Analysis)的方法来协助我们快速查找原因,如下表9.1所示:
表9.1 HVIGBT故障分析树
首先,我们根据失效的HVIGBT,初步得到可能的失效原因,按照表9.1所示,从上到下,从左到右依次查找,最终找到失效的原因。同时,三菱电机功率器件制作所经常通过设定实验条件,对功率模块进行故意破坏。根据实验结果,建立失效模式数据库。基于数据库,帮助客户分析可能的失效原因。
HVIGBT的过电压失效包含两类:VCE过电压和VGE过电压。VCE过电压失效的位置在芯片的边缘处,靠近场限环。如图9.1所示。
图9.1 VCE过电压失效
-
HVIGBT在关断时,由于电路回路中存在杂散电感,关断瞬间会产生尖峰电压,如果尖峰电压超过HVIGBT的额定电压,将可能造成HVIGBT击穿损坏。
-
关断电阻选择过小,小于HVIGBT的规格书推荐值。
-
吸收电路不合理,吸收电路未能有效抑制HVIGBT关断时的电压尖峰,反而增大电压尖峰。
VGE过电压失效的位置在栅极绝缘区域。破坏部位可能位于芯片任意部位,因为栅极氧化层几乎覆盖了整个HVIGBT芯片的表面。如图9.2所示。VGE过电压失效点在IGBT硅片表面并不明显,图9.2是用显微镜观测到的。

图9.2 VGE过电压失效IGBT在运行过程中,若出现窄脉冲,会对IGBT造成较大影响,甚至损坏。主要是因为内部IGBT在未完全开通情况下又重新关断,这一过程产生的di/dt要比正常完全开通再关断的情况大很多,这个大的di/dt又会产生高的关断尖峰电压,所以增大了HVIGBT过压失效的风险。图9.3给出了窄脉冲关断和正常关断di/dt的对比波形,可以看到两者的di/dt和VCE(peak)值相差很大。
(b)正常关断
图9.3 IGBT在窄脉冲关断和正常关断下的对比波形
在二极管导通过程中,若出现窄脉冲,会对二极管的反向恢复过程产生较大影响。影响之一就是二极管反向恢复的电压dv/dt会比正常反向恢复要大很多,dv/dt越大,二极管的反向恢复电压就越高,增大了过压失效的风险。另外一个影响就是会导致反向恢复电流和电压的振荡,振荡会影响系统的稳定性并且可能通过米勒电容反馈到门极。
图9.4 dV/dt Vs. ton图9.4为CM1200HC-66H的二极管导通时间与反向恢复电压dv./dt的关系,可以看到在导通脉宽小于10us的情况下,dv/dt急剧增大。
过电流失效的故障点集中于绑定线区域,因为电流流向是从硅片背部的集电极到绑定线部位的发射极,绑定线与硅片的连接处承受很大的热应力而导致该处熔断。
过温失效的故障点靠近芯片中心,因为该区域发热最严重。
图9.6 过温失效
-
散热设计不完善。
-
散热脂涂抹不合理。如果散热脂涂抹过薄或者过厚,会造成HVIGBT的壳与散热器的热阻增大,进而影响散热效果。
-
额定工作电流过大。
-
门极驱动电压不足导致的饱和压降上升。流过相同的集电极电流,门极驱动电压越小,HVIGBT的VCE(sat)越大,进而损耗越大。
-
HVIGBT开关频率过大或者过小导致损耗增加。
-
变流器输出频率过小。由于结-壳和壳-散热器的瞬态热阻原因,变流器输出频率越低(也即通态时间越长),HVIGBT的结温波动范围越大,如果最大结温超过最大允许结温可能会导致HVIGBT损坏。
图9.7为RBSOA失效的内部芯片图,典型特征为贯穿芯片的熔洞。IGBT先失效,二极管二次失效。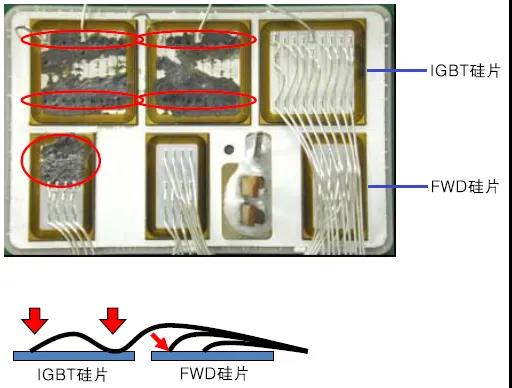
图9.7 RBSOA失效芯片图图9.8是CM1500HC-66R在VCC=2500V & IC=6078A的条件下 RBSOA 失效的案例,超过CM1500HC-66R规格书规定的电流限制是3000A。图9.9为RRSOA失效的内部芯片图。二极管先失效,IGBT二次失效。
图9.9 RRSOA失效芯片图图9.10是CM1500HC-66R在VCC=2500V & IC=1500A的条件下 RRSOA失效的案例,试验中为了达到较大的峰值功率,设置Rg=0Ω,同时增大母线杂散电感,可以看到反向恢复电压远远超过3300V。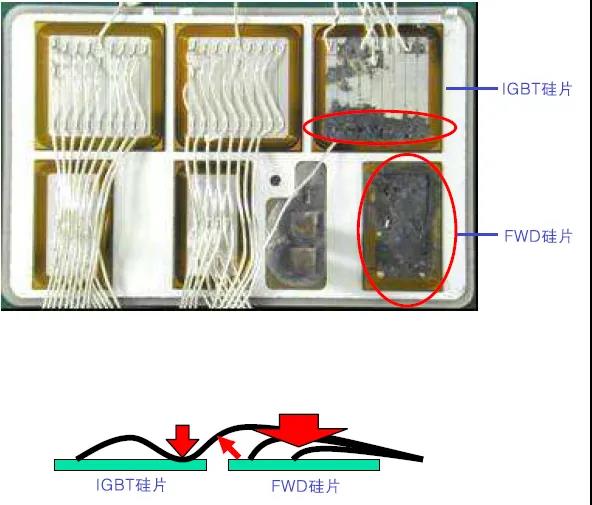
图9.10 RRSOA失效波形图图9.11为SCSOA失效的内部芯片图。仅有IGBT硅片失效。
图9.11 SCSOA失效硅片图
功率器件都有一个寿命期限,HVIGBT也不例外。由于不同材料之间温度变化而产生的应力是决定功率器件寿命的因素之一。如图9.12所示,为HVIGBT的内部结构图,不同材料的热膨胀系数不同。如图中上面红色圆圈所示,由于铝线和硅片热膨胀系数不同,模块工作时结温发生变化会导致它们之间产生机械应力,这种应力循环积累会使硅片与铝绑定线结合处发生龟裂而最终导致完全破坏,这种损坏模式称为功率循环寿命失效。同样如图中下面的红色圆圈所示,由于功率模块外壳温度的变化,模块绝缘基板和底板的膨胀系数不同导致它们之间的焊接层发生应力变形,该应力变形累积的结构就是焊接层龟裂,使得结壳热阻增加导致热破坏。但是同时,由于热阻增加,结温变化增加,功率循环耐受能力降低最终导致跟功率循环失效相同的绑定线剥离。
图9.12 HVIGBT剖面构造图功率循环寿命的损坏点为绑定线和硅片之间连接点。功率循环寿命损坏的初期表现是连接点的开裂。经过长时间运行后,最终绑定线会从硅片上脱落下来。如图9.13所示。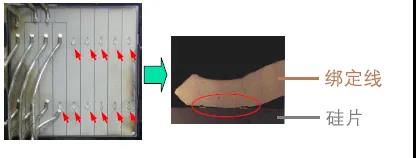
图9.13 功率循环失效
在功率模块壳温变化幅度大的工作模式下,由于绝缘基板和底板的热膨胀系数不同,绝缘基板和底板之间的焊接层将产生应力。这种应力的累积将会使焊接层产生裂纹。这种失效模式称为热循环失效。热循环寿命的损坏点为绝缘基板和底板之间焊接层。热循环寿命失效的初期表现是该焊接层从边缘部分的开裂,并逐步向焊接层的中央发展。如图9.14所示。三菱电机认为当开裂比例大于50%时,该HVIGBT的热循环寿命已经到期,器件已经损坏。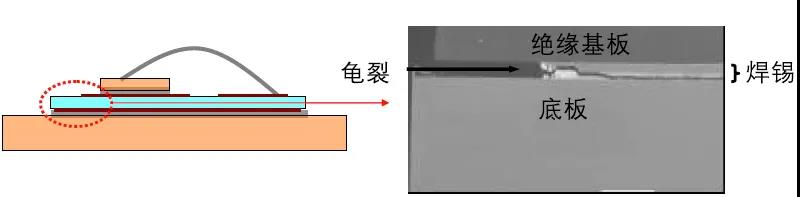
图9.14 热循环失效图9.15显示了某HVIGBT在长期运行后焊接层开裂的状况。该图是使用超声波扫描显微镜(SAT, scanning acoustic tomography)得到的。其中,紫色三角为已经开裂部分。由于器件发热的不均匀和焊接层自身的差异,开裂程度并不完全一致。另外,由于该焊接层的开裂也会影响硅片的散热,推高硅片的运行结温,加速HVIGBT的功率循环寿命损坏。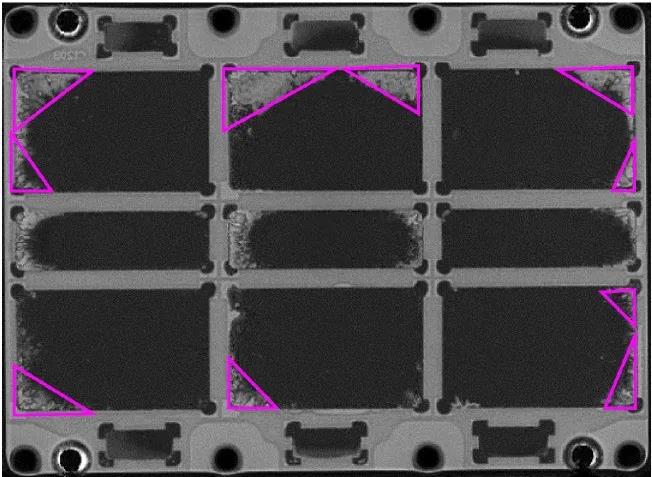
图9.15 某HVIGBT在长期运行后焊接层开裂状况
HVIGBT模块的安装请参考本书第10章相关内容,安装不当可能会造成损坏。
(1) 导热硅脂涂抹不均匀,涂抹量过少或者过多。如果硅脂涂抹不当,会造成HVIGBT底板与散热器之间的热阻增大(请参考10.2.1相关内容),增加HVIGBT模块过温失效的风险。
(2) 安装螺丝太长或者太短。如图9.16所示,过长的螺丝可能会导致封装破损或者电气短路。过短的螺丝会造成接触不良和热应力集中。
图9.16 过长的螺丝损坏IGBT(3)安装螺丝的扭矩没有按照推荐的扭矩。会导致接触不良和应力集中。
在实际应用中,HVIGBT的电压没有超过其额定电压,但是仍然有失效的情况,LTDS(Long Term DC Stability)失效是其中的一种可能原因。HVIGBT在高压条件下工作时会出现宇宙射线辐射引起的失效,属永久失效。通常这种失效的失效点是随机的,但是在大多数情况下,失效点是靠近硅片的边缘区域,如下图所示: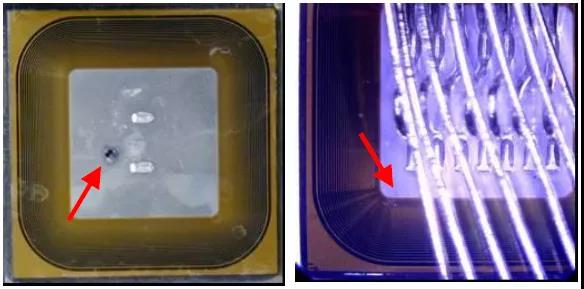
图9.18 LTDS失效宇宙射线一般来讲,指的是来自于宇宙中的一种具有能量的带电粒子流。宇宙射线带来的失效率会随着使用电压、温度、辐射度、海拔以及经纬度有关。HVIGBT的集电极和发射极之间的电压越高,或者海拔越高,由宇宙射线引起的失效率越高。相反,温度越高,由宇宙射线引起的失效率越低。
图9.19 CM1600HC-34H的LTDS曲线图9.19给出了CM1600HC-34H的LTDS曲线,红色为海拔4000米的曲线,黑色为海平面的曲线。从图中可以看出,在直流电压1100V时,海拔为海平面时失效率为20FIT,海拔为4000米时,失效率为200FIT。如果希望还海拔4000米处维持相同的失效率,需要将直流母线电压降至1030V。


 ×
×