×

×

 ×
×

图1:带有(0001)偏角的衬底上SiC外延生长概念图
在台阶控制外延生长中,当生长条件不合适时,原料在台面上而不是在台阶上成核并生成晶体,因此会生长出不同的晶体多型。混入外延层中的异种多型对器件来说是致命的缺陷,因此在台阶控制外延生长中,需要设置合适的偏角,以获得适当的台阶宽度,并优化原料气体中Si原料和C原料的浓度、生长温度等条件,选择在台阶上优先形成晶体的条件。目前市场上销售的4H型SiC衬底的表面呈现4°偏角(0001)面,是基于台阶控制外延生长的要求以及增加从boule中获得的晶圆数量这两个要求而决定的。
通过化学气相沉积法进行SiC外延生长时,通常使用高纯度氢气作为载体,向保持在1500~1600℃高温的SiC衬底表面供应SiH4等Si原料以及C3H8等C原料。在这种高温下,如果设备内壁等周围温度较低,向衬底表面的原料供应效率会大幅降低,因此采用热壁型反应器。关于SiC的外延生长设备,有多种方式,包括立式、水平式、多晶片式和单晶片式等。图2、图3和图4展示了各种外延生长设备反应器部分的气流和衬底配置示例。
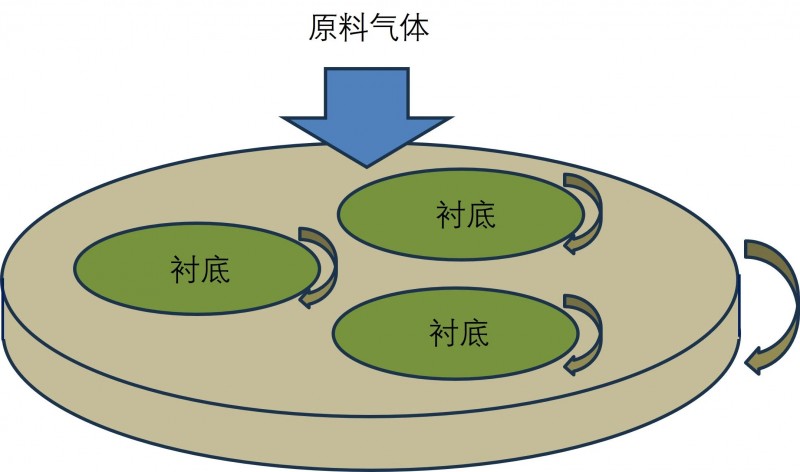
图2:多晶片自转公转型(从上方引入气体)

图3:多晶片公转型(从侧面引入气体)
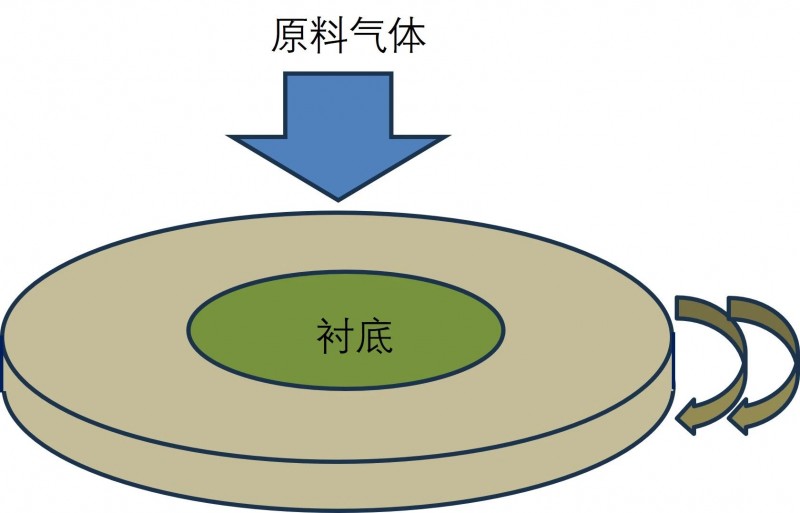
图4:单晶片高速旋转型
考虑到SiC外延衬底的量产,需考虑以下几个要点:外延层厚度的均匀性、掺杂浓度的均匀性、粉尘、产量、部件更换频率以及维护的便利性。关于掺杂浓度的均匀性,由于它直接影响器件的耐压分布,因此要求晶圆表面、批次内以及批次间的均匀性。目前,针对8英寸衬底的SiC外延生长设备的研发正在进行中,从降低成本的角度来看,期待能够实现更适合量产的设备。此外,附着在反应器内的部件和排气系统上的反应生成物是粉尘源,因此正在开发气体蚀刻技术,以方便清除这些粉尘。
通过SiC的外延生长,形成可用于制造功率器件的高纯度SiC单晶层。此外,外延生长还可以将衬底内存在的基面位错(BPD)转换为衬底/漂移层界面处的贯穿刃位错(TED)(参见图5)。正如第5讲中所述,当双极电流流过时,BPD会发生堆垛层错扩展,从而导致导通电阻增加等器件特性的劣化。然而,转换后的TED不会对器件的电气特性产生影响。因此,适当的外延生长可以大幅减少由于双极电流引起的劣化。
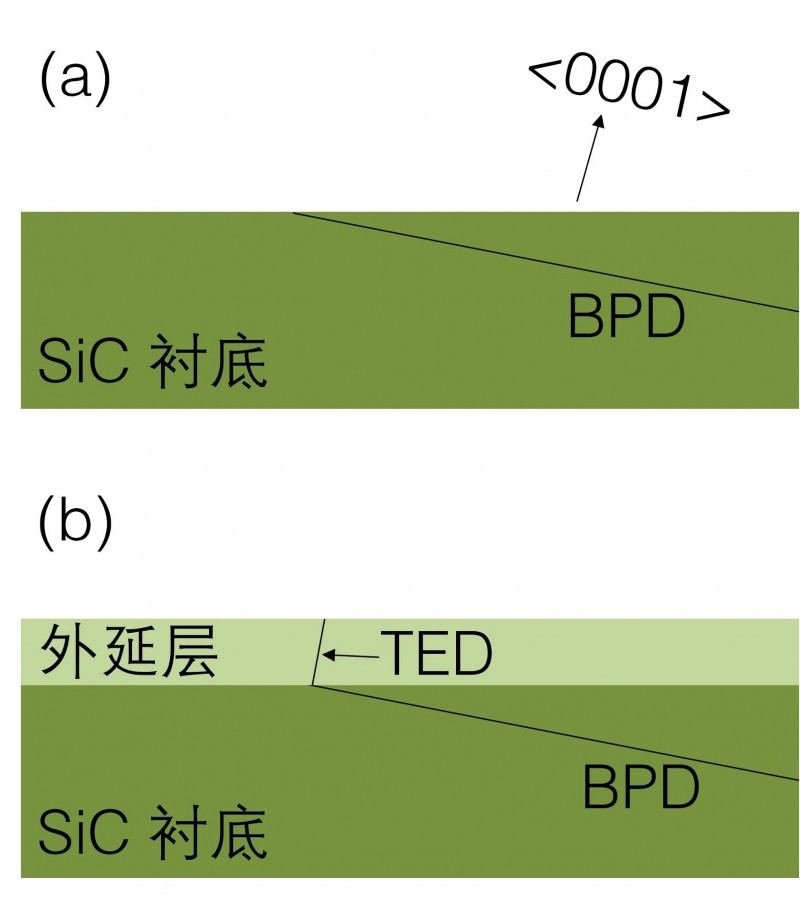
图5:SiC衬底中的BPD和转换后的TED横截面示意图
(a)外延生长前;(b)外延生长后;
通常,在SiC的外延生长中,会在漂移层和衬底之间插入缓冲层。缓冲层通常进行高浓度的n型掺杂,这有助于促进少数载流子的复合。缓冲层还承担着上述基面位错(BPD)转换的作用,并且对成本的影响也很大,是器件制造中的一项重要技术。